Calibration Standards
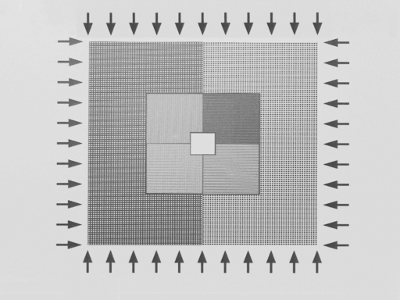
Atomic Force Microscopy has become a valuable tool not only for imaging surfaces but also for performing accurate measurements on the nanometer and micrometer scale. In order to make the most of their measurement capabilities, AFM systems should be properly calibrated.
We offer a range of calibration samples and tipcheck samples with a variety of geometries for calibration of different aspects of the AFM scanner including:
- Lateral (XY) and vertical (Z) scanner calibration
- Determination of the tip aspect ratio
- Detection of lateral non-linearity, hysteresis, creep and cross-coupling effects
- Determination of tip shape
- Analysis of scanner bow
- Testing of KPFM and EFM modes
Follow the links below for technical details and pricing:




